ИССЛЕДОВАНИЕ ЭЛЕКТРОФИЗИЧЕСКИХ ПАРАМЕТРОВ ГЕТЕРОСТРУКТУРЫ GAN НА ПОДЛОЖКЕ SIC ДЛЯ HEMT
Секция: 7. Материаловедение

XXV Студенческая международная заочная научно-практическая конференция «Молодежный научный форум: технические и математические науки»
ИССЛЕДОВАНИЕ ЭЛЕКТРОФИЗИЧЕСКИХ ПАРАМЕТРОВ ГЕТЕРОСТРУКТУРЫ GAN НА ПОДЛОЖКЕ SIC ДЛЯ HEMT
1. Назначение и конструкция гетероструктур.
Гетероструктуры на основе нитрида галлия предназначены для изготовления на их основе мощных полупроводниковых приборов и монолитных интегральных схем сверхвысокочастотного диапазона. В общем случае, такие гетероструктуры включают в себя следующий набор эпитаксиальных слоев (рисунок 1):
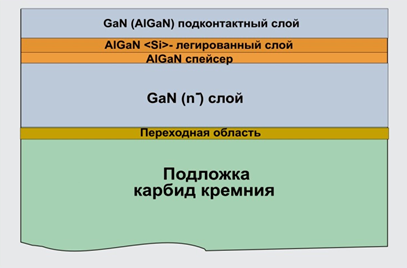
Рисунок 1. Схема гетероструктуры на основе нитрида галлия
Переходная область служит для уменьшения рассогласования параметров решетки инородной подложки и растущих на ней эпитаксиальных слоев нитрида галлия (и далее — всей гетероструктуры). Этот слой может быть различного состава (от GaN до AlN) и толщины (от 200 Ǻ до 0,5 мкм). Назначение этой области — создать условия для последующего роста совершенных эпитаксиальных слоев с заданными параметрами.
GaN слой предназначен для образования в его приповерхностном слое проводящего канала (двумерного электронного газа (ДЭГ) с высокой подвижностью носителей заряда), возникающего за счет разрыва зон и поляризационных эффектов при образовании гетероперехода AlGaN/GaN.Основным требованием к этому слою является структурное совершенство, достаточное для обеспечения высокой подвижности электронов, и высокое сопротивление. Толщина GaN слоя для структур, получаемых МОС-гидридным методом, составляет обычно 1—2 мкм.
Система AlGaN слоев образует с нижележащим слоем GaN гетеропереход, служащий для создания на границе ДЭГ газа с высокой подвижностью. Более широкозонный по сравнению с нитридом галлия и имеющий меньший параметр решетки, слой AlGaN создает необходимый разрыв зон и упругие напряжения на границе раздела, необходимые для создания высокой плотности носителей заряда в ДЭГ. Другим назначением барьерного слоя является обеспечение эффективного барьера Шоттки в области затворной металлизации. Указанные условия обеспечиваются при мольной доле Аl в слое не менее 0,25. В то же время, электрофизические свойства барьерного слоя не должны препятствовать возможности нанесения омических контактов к ДЭГ, поэтому толщина барьерного слоя не должна превышать 250—350 Ǻ. Для обеспечения более низкого контактного сопротивления и более эффективного наполнения двумерного канала носителями барьерный слой обычно частично легирован — часть его (спейсер толщиной 30—50 Ǻ), примыкающая к каналу-нелегирована, внутренняя часть (донорный слой толщиной 50—200 Ǻ) — легирована Si до уровня (1—5) 1018 см-3, верхняя часть (толщиной 50—150 А), примыкающая к затвору, не легирована. При этом, для ряда применений этот верхний слой может быть слоем GaN.
Необходимыми критериями работоспособности транзисторных гетероструктур являются высокое сопротивление изолирующего слоя и низкое слоевое сопротивление гетероперехода, определяемое плотностью носителей двумерного электронного газа и их подвижностью.
2. Формирование гетероэпитаксиальных структур.
Для получения полуизолирующих слоев нитрида галлия применялись методы легирования эпитаксиальных слоев примесями, создающими глубокие акцепторные уровни — Mg, Fe, Zn [1, p. 1804607; 4; 6; 7], которые позволили получить в принципе положительные результаты. Так, в работе [7] показана возможность получения слоев GaN<Fe> с удельным сопротивлением >108 Ом см; продемонстрированы результаты применения гетероструктур с таким буферным слоем для изготовления мало сигнальных HEMT, которые показали неплохие рабочие характеристики. Тем не менее, по аналогии с развитием технологии полевых транзисторов на основе арсенида галлия, представляется, что технология изготовления буферных слоев нитрида галлия с применением указанного выше метода не является оптимальной, поскольку высокая концентрация глубоких компенсирующих центров может обуславливать высокий уровень шумовых характеристик и деградацию приборов. В связи с этим более интересными с практической точки зрения представляются результаты исследований, в которых изучалась возможность получения высокоомных слоев GaN посредством подбора соответствующих технологических условий их получения [3—5]. В работе [3] изучалось влияние времени рекристаллизации зародышевых слоев и скорости роста основного слоя GaN на электрофизические свойства последних. Показано, что укороченное время отжига и повышенная скорость роста приводят к увеличению сопротивления эпитаксиальных слоев, однако при этом значительно увеличивается число пирамид роста. В [5] показано, что удельное сопротивление (ρ) эпитаксиальных слоев может меняться более чем на 8 порядков величины при изменении давления в реакционной камере. Максимальная величина ρ составила 1010 Ом см при давлении 100 торр; увеличение давления, при котором проводилось выращивание слоев, до 500 торр приводило к увеличению ρ до 102—104 Ом см. Результаты своей работы авторы [8], объясняют формированием большого количества глубоких акцепторных центров за счет сегрегации атомов углерода, на проникающих краевых дислокациях, количество которых возрастает с уменьшением давления в реакторе вследствие уменьшения в этих условиях размеров зародышей нитрида галлия и одновременного повышения их плотности.
Из приведенного выше следует, что тщательный анализ зависимости электрофизических параметров эпитаксиальных слоев нитрида галлия от условий их получения позволяет находить пути придания выращиваемому материалу необходимые для конструирования приборов свойства
Уровень концентрации носителей заряда в нелегированном слое GaN значительно зависит от условий роста. В условиях наших экспериментов установлено, что основным фактором, определяющим фоновый уровень носителей заряда в нелегированном буферном слое GaN, является давление в реакционной камере. Так, при изменении давления от 500 до 200 мм.рт.ст. этот уровень изменяется почти на два порядка и составляет ~1014 см-3.
Формирование эпитаксиальных слоев AlGaN гетероперехода GaN/ AlGaN является чрезвычайно ответственной стадией получения гетероструктуры в целом, определяющей ее качество с точки зрения достижения требуемых рабочих характеристик транзисторов и их надежности.
Величина плотности носителей заряда на гетерогранице увеличивается с ростом содержания Al в слое AlGaN (рисунок 2). Увеличение плотности носителей заряда является следствием увеличения пьезоэлектрической поляризации и увеличения заряда на гетерогранице. Практически реализовать такую зависимость в полной мере не удается, поскольку при концентрации Al более 35—40 % наблюдается резкое ухудшение качества гетероперехода. При больших концентрация алюминия (более 40 %) имеет место также ухудшение морфологии слоев и даже их растрескивание.
Резкое увеличение слоевого сопротивления при концентрации алюминия более 40 % свидетельствует о том, что в слоях AlGaN с таким содержанием Al имеет место релаксация напряжений и практически отсутствует эффект пьезоэлектрической поляризации [2, p. 2701].
Как показано в работе [2, p. 2701], улучшение качества гетероперехода достигается заменой слоя отмеченной барьерного слоя AlGaN однородного состава на сверхрешетку AlN/ GaN со средним содержанием Al в 40 %; величина слоевого сопротивления структуры при этом была менее 200 Ом.
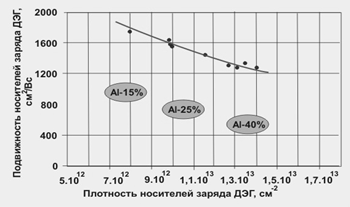
Рисунок 2. Зависимость параметров гетероструктур от содержания Al в слоях AlxGa1-xN
Оптимизация толщины слоя AlGaN также имеет большое значение для функционирования HEMT. Как показано в работе [8, p. 2668], транзисторы, изготовленные на базе гетероструктурGaN/ Al0.32G0.68N, демонстрировали разную скорость деградации, находившуюся в корреляции с толщиной слоя барьерного слоя (толщина последнего изменялась в диапазоне 13.8—26 нм). Наименьшая скорость деградации наблюдалась у транзисторов с толщиной барьерного слоя 13.8 нм, наибольшая соответствовала толщине 26 нм.
Существенное улучшение свойств гетероперехода достигается введением в его структуру так называемого спейсера — слоя широкозонного AlN толщиной 1—2 нм, располагаемого между слоями GaN и AlGaN. Введение этого слоя вызывает увеличение разрыва зон проводимости между GaN и AlGaN за счет ввода дополнительного поляризованного диполя AlN. Увеличение разрыва зон проводимости препятствует проникновению электронов ДЭГ в слой AlGaN, т. е. способствует локализации носителей заряда ДЭГ. Следствием этого является увеличение подвижности носителей заряда двумерного электронного газа.
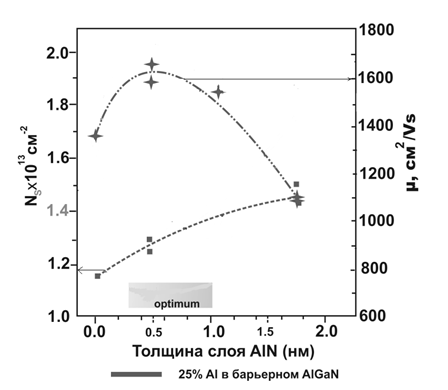
Рисунок 3. Зависимость концентрации носителей заряда и их подвижности в ДЭГ от толщины слоя AlN
Действительно, при толщине слоя AlN 0,5—0,7 нм наблюдается значительное увеличение подвижности носителей заряда (до 1700 см2/В. с) (рисунок 3). В ходе работы проводилась также и оптимизация режимов получения каждого слоя в структуре.
Характеристики двумерного электронного газа зависят также и от толщины барьерного слоя AlGaN — рисунок 4. С увеличением толщины слоя увеличивается концентрация носителей заряда, но уменьшается их подвижность.

Рисунок 4. Зависимость параметров двумерного электронного газа в гетероструктурахAlGaN/GaN от толщины барьерного слоя AlGaN
В силу небольшого различия параметров кристаллических решеток GaN и SiC гетероструктуры на подложках карбида кремния отличаются лучшим структурным совершенством в сравнении с материалом, выращенном на подложках сапфира (ШКК составило величину 240—255 угл/сек и 290—315 угл/сек соответственно (рисунок 6)). Данное обстоятельство определило более высокие электрофизические характеристики гетероэпитаксиальных структур на подложках SiC.
Содержание Al в слое AlGaN и структурное совершенство получаемых слоев оценивалось по кривым рентгеновской дифракции; вид получаемых кривых приведен на рисунке 5.

Рисунок 5. Кривые рентгеновской дифракции структур AlGaN/GaN

Рисунок 6. Распределение полуширины кривых качания образцов выращенных на подложке а)SiC б) сапфира
Выводы.
1. Нитриды 3 группы обладают уникальными свойствами для создания транзисторов. Широкие запрещенные зоны, возможность перехода по составу и Eg от 3.4 эВ (GaN) до 6.22 эВ (AlN), а также создания высоких потенциальных барьеров на гетерогранице за счет больших разрывов зоны проводимости; на порядок более высокая плотность электронов ns в 2Dканале чем в GaAs, высокие скорости насыщения vs.
2. Среди материалов подложек (Si, Al2O3, SiC) наибольший интерес для использования в мощных СВЧ-транзисторах представляет карбид кремния вследствие очень высокой теплопроводности подложечного материала (втрое выше чем у подложек кремния), низкого рассогласования решеток, которое составляет 3,5 % против 17 % у кремния или 14 % у сапфира, а также за счет значительно более низкой разницы коэффициентов термического расширения (для SiC она составляет 18 % против 50 % у Si и 35 % у сапфира).
3. 3.Введение спейсера AlN способствует локализации носителей заряда ДЭГ, что является следствием увеличения разрыва зон проводимости между GaN и AlGaN и выражается в увеличении подвижности и концентрации носителей заряда.
4. Исследовано влияние толщины слоя AlGaN на электрофизические свойства гетероструктуры. Полученные результаты свидетельствуют о том, что с увеличением толщины слоя AlGaN увеличивается концентрация носителей заряда, но уменьшается их подвижность.
5. Исследовано влияние концентрации Al в слое AlnGan-1N. Увеличение концентрации Al увеличивает концентрацию носителей заряда в ДЭГ, но уменьшает их подвижность, что является следствием увеличения пьезоэлектрической поляризации и увеличения заряда на гетерогранице. При концентрации Al более 40 % наблюдается резкое ухудшение качества гетероперехода. При концентрации Al ~25 % ДЭГ характеризовалась концентрацией носителей заряда NS=1013 см-2 и подвижностью µ=1600 см2/Вс, что является хорошим показателем для HEMT.
Список литературы:
1. Akasaka T. et. al. // Appl. Phys. Lett. — 2004. — vol. 85. — Р. 1804607.
2. Ho I., Stringfellow G.B. — Solid phase immiscibility in GaInN // Appl. Phys. Lett. — 1996. — vol. 69. — Р. 2701.
3. Krömer M. C. J. C. M. // Gallium nitride-based high-power heterosructure field-effect transistors: design, technology and characterization. Eindhoven: TechnischeUniveriteit Eindhoven. — 2006. — ISBN-13:978-90-386-1893-7.
4. Lundin V. et. al. // 15-th International Conference on Metal Organic Vapor Phase Epitaxy:Nitride (LED). — 2010.
5. Pankove J.I. and Moustakas T.D. — Gallium Nitride (GaN) I // San Diego, Academic Press. — 1998.
6. Xai Y. et. al. // MagEX conference.-Buffalo University. — 2008.
7. Yang C-C. // Final Report.-Graduate Institute of Electro-Optical Engineering National Taiwan University. — 2006.
8. Zhang J. et. al. — Enhanced luminescence in InGaN multiple quantum wells with quaternary AlInGaN barriers // Appl. Phys. Lett. — 2000. — vol. 77. — Р. 2668.





