ИССЛЕДОВАНИЕ ТОНКИХ ПЛЕНОК ТА2О5 МЕТОДОМ СПЕКТРАЛЬНОЙ ЭЛЛИПСОМЕТРИИ
Секция: 11. Нанотехнологии

XXVII Студенческая международная заочная научно-практическая конференция «Молодежный научный форум: технические и математические науки»
ИССЛЕДОВАНИЕ ТОНКИХ ПЛЕНОК ТА2О5 МЕТОДОМ СПЕКТРАЛЬНОЙ ЭЛЛИПСОМЕТРИИ
Приводятся результаты исследования эллипометрических параметров тонких наноразмерных пленок Та2О5, установлена связь этих параметров с углом падения луча и шероховатостью поверхности.
В последнее время наноразмерные пленки Та2О5 широко используются в микро- и наноэлектронике благодаря своим электрофизическим свойствам.
В работе был исследованы пленки Та2О5 толщиной 100—200 нм на подложке монокристаллического кремния, полученные ВЧ магнетронным распылением мишени металлического тантала в атмосфере кислорода [4].
В работе проводились измерения пленок методом спектральной эллипсометрии.
Параметры y и D являются основными оптическими параметрами в эллипсометрии. Они являются чувствительными к оптическим свойствам пленки, что позволяет определить ее структуру, состав и качество [2].
Для исследования использовался спектральный эллипсометрический комплекс «Эллипс 1891 САГ», работающий в диапазоне длин волн 350—1000 нм и предназначенный для проведения прецизионных измерений толщины однослойных и многослойных тонкопленочных структур, а также исследования спектральных оптических постоянных (показателя преломления и коэффициента поглощения), структурных свойств материалов (пористость; наличие, концентрация и распределение примесей в пленке) [3].
Измерения y и D проводились на разных длинах волн: 400, 600 и 1000 нм и при углах падения луча от 45 до 70 градусов.
На рисунке 1 представлена зависимость параметра y от угла падения луча α.
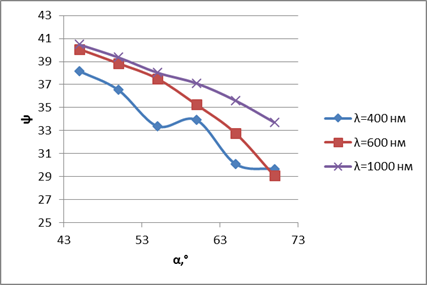
Рисунок 1. Зависимость y от угла падения α
Как видно из рисунка 1 при увеличении угла падения луча параметр y убывает и стремится к минимальному значению.
На рисунке 2 представлена зависимость параметра D от угла падения α.

Рисунок 2. Зависимость D от угла падения α
Из рисунка 2 видно, что при увеличении угла падения параметр D уменьшается. Вероятнее всего, причиной данного явления является шероховатость поверхности пленки. Фотографии профиля поверхности с высоким разрешением показали наличие неровностей на поверхности пленки высотой 10—15 нм [1].
На рисунке 3 представлена морфология пленки Ta2O5.

Рисунок 3. Морфология пленки Ta2O5
Зная основные оптические параметры y и D можно вычислить показатель преломления n и толщину пленки d.
На рисунке 4 представлена зависимость показателя преломления от угла падения луча.
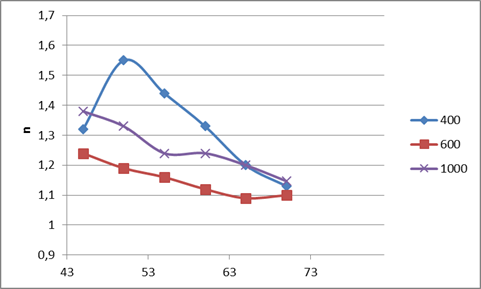
Рисунок 4. Зависимость показателя преломления n от угла падения луча
На рисунке 5 представлен график зависимости толщины пленки d от угла падения луча.

Рисунок 5. Зависимость толщины пленки d от угла падения луча
В результате данной работы установлено, что измеряемые эллипсометрические параметры, а, следовательно, и вычисляемые с помощью них показатель преломления и толщина пленки, являются функциями угла падения света. Проводя угловые измерения, можно получить информацию о шероховатости пленки. На основании чего можно сделать вывод о состоянии поверхности пленки.
Анализируя данные, можно сделать вывод о влиянии шероховатости пленок на результаты измерений. В результате этого влияния пленка при измерении может быть приближенно приравнена к некой композиции из самого оксида и вещества окружающей среды. Показатель преломления в данном случае принято считать неким эффективным параметром данной системы, определяемым соотношением объемов. Что обуславливает некоторое снижение измеренного показателя преломления.
Список литературы:
1. Громов В.К. Введение в эллипсометрию / В.К. Громов — Ленинград 1986, — 190 с.
2. Резвый Р.Р. Эллипсометрия в микроэлектронике. — М.: Радио и связь, 1983. — 120 с., ил.
3. Смирнов С.В., Чистоедова И.А., Литвинова В.А. Структуры и свойства тонких пленок тантала, полученных магнетронным распылением / Доклады Томского Государственного Университета Систем Управления и Радиоэлектроники, ТУСУР, 2005. № 4, С. 80—83.
4. Швец В.А, Спесивцев Е.В. Эллипсометрия / Е.В Спесивцев, В.А Швец — Новосибирск 2013, — 87 с.





