Расчет технологических параметров при изготовлении солнечного элемента на основе гетероструктуры AlxGa1-xAs - GaAs
Секция: Технические науки
лауреатов
участников
лауреатов


участников



XXXIX Студенческая международная заочная научно-практическая конференция «Молодежный научный форум: технические и математические науки»
Расчет технологических параметров при изготовлении солнечного элемента на основе гетероструктуры AlxGa1-xAs - GaAs
Использование солнечных элементов на основе гетероструктур AlGaAs -GaAs позволяет изменять в широком диапазоне рабочие характеристики солнечных элементов. Посредством изменения концентрации веществ (Ga, Al) входящих в твердый раствор AlxGa1-xAs, можно расширить возможности создания солнечных ячеек с точно заданными параметрами и структурой [1]. Изменения ширины запрещенной зоны в слое AlxGa1-xAs влияет на спектр поглощения фотонов этим слоем, изменения периода решетки осаждаемого материала позволяет контролировать максимальную толщину осаждаемого слоя, которую мы можно осадить без образования дислокаций. Если толщина напряженного эпитаксиального слоя меньше так называемой критической толщины, то слой оказывается упруго напряженным (псевдоморфным) [1]. Величина упругих напряжений определяется рассогласованием параметров решеток эпитаксиального слоя a0 и подложки aS рисунок 1.
После превышения критической толщины напряженная решётка начинает релаксировать с образованиям дислокаций несоответствия рисунок 1 (в). В случае наличия на гетерогранице каких-либо рода дефектов, к примеру точечные рассогласования, это ведет к негативным последствиям в электронных устройствах, токи утечки, увеличения процессов рассеяния, шумы и т.д. [1]. При изготовлении солнечных элементов необходимо учитывать этот фактор который безусловна негативно сказывается на КПД солнечных элементов. В данной работе будет осуществлен расчёт зависимости ширины запрещенной зоны от состава, и максимальной возможной толщины при которой не образуются дислокации несоответствия для солнечного элемента на основе гетероструктуры AlxGa1-xAs/GaAs рисунок 2 [4;6].

Рисунок 1. Схема расположения атомов на гетерогранице: а) решеточно согласованная гетероструктура aS = a0, б) псевдоморфная гетероструктура aS < a0, в) релаксированная гетероструктура aS < a0,

Рисунок 2. Структура солнечного элемента на основе гетероструктуры AlxGa1-xAs/GaAs
Для начала осуществим расчет постоянной решетки от состава для AlxGa1-xAs от x=0 до x=1. Постоянная решетки для AlAs и GaAs aAC = 5.661 А и aBC = 5.653 А соответственно. Для расчета периода решетки а(х) твердого раствора вида AxB1-xC воспользуемся правилом Вегарда, где период решётки линейно зависит от состава х и периодов решетки входящих в это соединения с помощью выражения (1), рисунок 3 [2;3;5].
 (1)
(1)

Рисунок 3. Изменения постоянной решетки a(x) от состава для AlxGa1-xAs
Затем находим значений рассогласований периодов решеток  материалов AlxGa1-xAs и GaAs от их состава используя выражения (2), рисунок 4 [3].
материалов AlxGa1-xAs и GaAs от их состава используя выражения (2), рисунок 4 [3].
 (2)
(2)

Рисунок 4.Рассогласований постоянных решеток ε0(x) от состава для слоев AlxGa1-xAs/GaAs
Зададим коэффициенты Пуассона VGaAs=0.31 μ и VAlAs=0.352 μ. С помощью выражения (3) рассчитаем коэффициенты Пуассона для твердого раствора AlxGa1-xAs [2]:
 (3)
(3)
Теперь определим толщину слоя AlxGa1-xAs при которой начинается генерация дислокаций несоответствия на слое GaAs с помощью выражения (4), рисунок 5.
 (4)
(4)

Рисунок 5. Критическая толщина эпитаксиального слоя от состава для слоев AlxGa1-xAs/ GaAs
Зависимость ширины запрещенной зоны от состава твердого раствора AxB1-xC описывается выражением (5) рисунок 6.
Eg (x) = x ∙ Eg AC + (1 - x) ∙ Eg BC – c ∙ x · (1 – x) (5)
где: c – параметр изгиба, который равен для 0,143 для AlxGa1-xAs
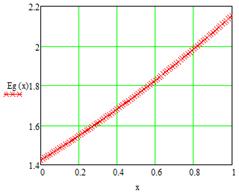
Рисунок 6. Зависимость ширины запрещенной зоны от состава для AlxGa1-xAs
В результате проведенных расчетов была определена зависимость, ширины запрещенной зоны от состава слоя AlGaAs, и периода решетки от состава. Изменяя состав твердого раствора AlGaAs, а также других соединений относящийся к классу соединений AIIIBV мы можем получать солнечные элементы на основе данных гетероструктур с требуемыми характеристиками.

