Обзорная характеристика типов травления для получения меза-структур при формировании ЛЛД.
Секция: Технические науки

IV Студенческая международная научно-практическая конференция «Технические и математические науки. Студенческий научный форум»
Обзорная характеристика типов травления для получения меза-структур при формировании ЛЛД.
Введение
На современном уровне известны такие системы как Nd:YAG и Yb:YAG и другие. В них используется полупроводниковая накачка для увеличения КПД. Полупроводниковая накачка – накачка из полупроводниковых лазерных диодов, основным достоинством которой является узкий спектр излучения и высокое преобразование электрической энергии в излучение.
Однако для получения высокоэффективных и малогабаритных источников полупроводниковой накачки требуется достичь максимальной плотности оптической накачки, получаемой с линейки лазерных диодов (далее по тексту ЛЛД). Данного результата можно достичь за счет увеличения количества эммитеров на ЛЛД. При таком заполнении требуется учитывать оптическое электрическое влияние эммитеров друг на друга. Для этого необходимо исследовать формирование меза-структур. Для полупроводниковых структур эффективной структурой является ‘зарощенная меза’.
Травление для получения меза-структур
В процессе создания меза-структуры нельзя обойтись без процесса травления. Травление наиболее повторяющийся процесс при создании меза-структуры. Термин травление обозначает химическое растворение части обрабатываемого материала, основанное на окислении полупроводникового материала и последующем удалении образовавшихся окислов. При создании меза-структуры именно травление играет важную роль, так как с помощью него мы получаем канавки различной глубины и ширины.
Различают некоторые виды травления:
· Ионное травление;
· ионно-плазменное травление;
· ионно-лучевое травление;
· газовое травление;
· жидкостное.
Ниже рассмотрим каждый вид в отдельности и сделаем выбор типа травления для формирования меза-структур при формировании ЛЛД.
Ионное травление
Ионное травление (ИТ) — процесс удаления распылением слоя вещества с находящимися на его поверхности загрязнениями и адсорбированными газами. «Травление выполняют в специальных вакуумных установках путем бомбардировки пластин или подложек (мишеней) ускоренными положительными ионами инертных газов».[1] Наиболее часто для распыления применяют аргон, так как он имеет не высокую стоимость, обеспечивает эффективное распыление.

Рисунок 1. Схема реактивного ионного травления RIE
Ионно-плазменное травление
При ионно-плазменном травлении очистка поверхностного слоя материалов осуществляется за счет распыления инертных газов, которые в свою очередь химически не реагирует на состав материала. Распыление находится в контакте с зоной плазмы, а необходимая энергия ионов обеспечивается подачей на материал отрицательного смещения. «Ионно-плазменное травление выполняют в диодных или триодных камерах вакуумных установок. Травление в диодных камерах (рис.2) проводят при постоянном или переменном ВЧ напряжении».[2, c. 254]. Пластины помещаются на катоде, а из вакуумной камеры откачивают воздух и через игольчатый натекатель напускается газ - аргон до рабочего давления.
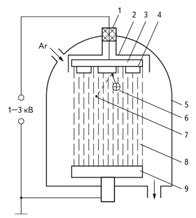
Рисунок 2 – Схема процесса ионно-плазменного травления в диодной вакуумной камере: 1 – изолятор; 2 – экран; 3 – катод; 4 – пластины; 5 – вакуумная камера; 6 – бомбардирующий ион аргона; 7 – частица распыленной пластины; 8 – плазма тлеющего разряда; 9 – анод
Ионно-лучевое травление
Ионно-лучевая технология позволяет, как вытравливать, так и осаждать тонкие пленки с помощью пучка положительно заряженных ионов в условиях глубокого вакуума.
Для травления пучок направляют на подложку, тем самым создается конкретный рисунок. Для осаждения ионный пучок распыляет мишень, находящуюся так, чтоб распыленный материал оседал на заданную подложку. Свойства осаждаемых пленок будут зависеть от свойства распыляемой мишени, от параметров распылительного ионного пучка (поток, энергия и др.) и от взаимного расположения источника ионов, мишени и подложки. При ионно-лучевом травлении мишени расположены вне плазмы газового разряда. Это позволяет регулировать параметры процесса, энергию ионов, плотность тока ионного луча и угол падения ионов на обрабатываемую поверхность независимо друг от друга.
Ионно-лучевого травления обладает рядом преимуществ:
· Позволяет независимо контролировать поток ионов и энергию пучка;
· процесс проходит при низких рабочих давлениях;
· обеспечивает анизотропное травление;
· обеспечивает травление всех известных материалов;
· позволяет контролировать профиль/боковые стенки тренча путем изменения угла пучка относительно обрабатываемой поверхности.
А также его недостатки:
· Низкие скорости травления (0,1–1 нм/с);
· значительные радиационные и тепловые воздействия, вызывающие разрушения контактных масок, деградацию электрофизических параметров структур и необходимость охлаждения образцов при травлении.
Газовое травление
Суть газового типа травления заключается в химическом взаимодействии поверхностей с газообразными веществами и новом появлении при этом быстро улетучиваемых соединений. В процессе данного типа травления все загрязнения удаляются вместе с стравленным поверхностным слоем пластин.
Газовое травление как метод очистки применяется непосредственно перед теми технологическими процессами, в которых определяющую роль играет структура слоя поверхности. В качестве травителей используют смеси водорода или гелия с галогенами (фтор, хлор, бром), галогеноводородами (HBr, HC1), сероводородом, гексафторидом серы.
Основные преимущества:
· Сухой процесс;
· не воспламеняющиеся и относительно безвредные реагенты;
· высокая разрешающая способность;
· возможность автоматизировать процесс;
· более чистый процесс.
Недостатки:
· Травиться может как маска, так и слой поверхности.
Жидкостное травление
В основе травления жидкостного типа лежит химическая реакция травителя и твердого тела, в результате которой образуется растворимое соединение. Подбор хим. состава, концентрации и температуры травителя задают скорость травления (порядка 0,1 мкм / мин) а такжетолщину удаляемого слоя. Есть возможность осуществить локальное травление, через специально изготовленную маску.
Применяемые травители должны обладать следующими требованиями:
· Травители не должны нарушать резистивный слой поверхности, т.е. обладать селиктивностью;
· травители не должны образовывать продукты реакции способствующих отслаиванию пленки резистивного покрытия по контуру элементов рисунка;
· с помощью скорости травления должны обеспечивать минимальную плотность дефектов получившегося рисунка.
К сожалению, данный процесс травления изотропен, то есть неизбежно приводит к боковому подтравливанию элементов рисунка.
Результат качества травления зависит от уровня сформированного защитного покрытия, так называемого фоторезиста, типа травителя, температуры травления и толщины стравливаемого материала.
«Чтобы обеспечить качественное и контролируемое травление пластин, используют специальные колокола, которые вращаются вокруг оси под углом 15-20 градусов (Рисунок 3). Пластины воском или химически стойким лаком наклеивают на фторопластовые диски и помещают в колокол с травителем. При вращении колокола диск катится по его стенке. Такая конструкция установки обеспечивает хорошее перемешивание травителя». [3, c. 113].

Рисунок 3. Схема установки контролируемого травления: 1 - колокол, 2 – электродвигатель, 3 – пластина, 4 – фторопластовый диск, 5 – травитель
Заключение
В данной работе представлена обзорная характеристика видов травления для получения канавок при формировании меза-струткуры и сделан выбор в сторону использования жидкостного типа травления. Данный метод травления является эффективным, так как происходит более быстрое удаление большей части объема материала. Выбор был обусловлен, степенью заполнения диодов в линейке, а именно при заполнении менее 60% диодов использовалось жидкостной тип травления. При заполнении более 60 % диодов в линейки, рекомендуется использовать гибридное травление, а именно жидкость плюс газ.





