ИССЛЕДОВАНИЕ ТЕХНОЛОГИИ ПОЛУЧЕНИЯ СЕРИИ ЗНАЧЕНИЙ ТОЛЩИНЫ СЛОЯ ZnO В СТРУКТУРЕ ZnO/Si(B)/Si(P) ДЛЯ КОДИРОВАНИЯ КОЭФФИЦИЕНТОВ КВАТЕРИОНА СРЕДЫ ПРОЦЕССОРА
Конференция: CCLIV Студенческая международная научно-практическая конференция «Молодежный научный форум»
Секция: Технические науки

CCLIV Студенческая международная научно-практическая конференция «Молодежный научный форум»
ИССЛЕДОВАНИЕ ТЕХНОЛОГИИ ПОЛУЧЕНИЯ СЕРИИ ЗНАЧЕНИЙ ТОЛЩИНЫ СЛОЯ ZnO В СТРУКТУРЕ ZnO/Si(B)/Si(P) ДЛЯ КОДИРОВАНИЯ КОЭФФИЦИЕНТОВ КВАТЕРИОНА СРЕДЫ ПРОЦЕССОРА
Введение.
Благодаря уникальному спектру свойств материала тонкие пленки оксида цинка нашли широкий спектр применений. Оксид цинка можно применять в качестве низкоомных прозрачных в видимой и ближней инфракрасной областях спектра покрытий, благодаря его оптическим свойствам. Также можно применять данный материал в приборах на поверхностных акустических волнах, таких как фильтры, линии задержки звукопроводы и резонаторы. Оксид цинка также можно использовать в качестве сенсоров для газоаналитических приборов, так как данный материал способен абсорбировать в нагретом состоянии.[1]
Получить тонкие пленки оксида цинка можно получить несколькими способами, одним из них является метод реактивного магнетронного распыления. Данный метод подходит больше всего, так как напыления происходит равномерно на относительно большую площадь поверхности. Так же к плюсам данного метода можно отнести, более плотную микроструктуру получаемых пленок, дешевизну, возможность напылять при относительно низких температурах и относительно простое управление оборудованием.
Цель: Исследование параметров ZnO.
Задачи: Методика получения пленки, виды полученных пленок и контроль из параметров.
1. Технология получения пленок оксида цинка.
1.1. Технология и импульсного лазерного напыления.
ИЛН – это процесс осаждения на поверхности подложек из металла, или керамики плeнoк, которые получились в результате взаимодействия мишени с лазерным импульсом в вакуумной камере c участием плазменного абляционного факела. Этот метод получения пленок позволяет их выращивать как с аморфной структурой, так и с кристаллической.
1.2. Технология резистивного термического испарения.
Этот процесс использует электрическую энергию для нагрева испаряемого материала до такой температуры, при которой его атомы достаточно быстро испаряются. Процесс осуществляется в высоком вакууме, что позволяет увеличить длину свободного пробега атомов и получать наиболее чистые пленки.
1.3. Технология электронно-лучевого испарения.
В основе метода лежит принцип испарения материала мишени-анода за счет воздействия на него потока электронов, эмитируемого катодом электронно-лучевого испарителя. Поток электронов фокусируется на мишени при помощи магнита. Электронный луч нагревает мишень до температуры плавления, а затем и испарения. Испарение происходит в высоком вакууме (до 10-8 Па), что обеспечивает высокую чистоту процесса. Материал мишени обычно закладывают в тигель, либо испарение осуществляют из жидкой лунки массивной мишени, что исключает загрязнение материалом тигля.
1.4. Технология магнетронного распыления.
Простейшая магнетронная распылительная система (МРС) – это диодная (катодная) система c применением магнитного поля. Обычно магнитная система на постоянных магнитах или же электромагнитах размещается под катодом-мишенью, создавая над его поверхностью замкнутое поле в форме арки, т.e. реализуемый в МРС аномальный тлеющий разряд происходит в скрещенных между собой электрическом и магнитном полях. Электроны, эмитируемые катодом-мишенью под действием ионной бомбардировки, захватываются магнитным полем и совершают циклоидное движение по замкнутым траекториям недалеко от поверхности мишени. B результате огромного количества столкновений электронов с атомами рабочего газа резко возрастает степень ионизации плазмы и увеличивается плотность ионного тока. Это приводит к увеличению скорости распыления материала мишени. Поскольку магнитная индукция увеличивает траекторию движения электронов, то при этом возрастает число их столкновений с атомами рабочего газа и можно считать, что наложение магнитного поля эквивалентно увеличению давления рабочего газа в обычной диодной системе. [2]
2. Технология напыления оксида цинка.
В качестве напыляемой пленки были выбраны многослойные пленки ZnO/Si(B)/Si(P) с разным временем напыления ZnO.
2.1. Очистка подложек от загрязнений.
Поверхность подложек сильно зависит от ее обработки. Чтобы увеличить качество наносимых покрытий нужно очистить всю поверхность подложки от загрязнений. В самом начале тщательно вымоем подложку в воде с мыльным раствором.
После этого ставим подложки на 15 минут в ультразвуковую ванну, в которую предварительно была налита дистиллированная вода. После этих процессов помещаем подложки в устройство, которое чистит подложки парами ацетона. Находиться подложки там будут до тех пор, пока конденсированный ацетон не покроет до конца подложки.
2.2. Установка подложек
В подложкодержатели устанавливаем подложки. Во время загрузки необходимо держать подложки за края, чтобы на их поверхность не попала грязь, иначе мы не получим расчитываемую толщину пленки и, дальнейшие исследования будут неверными.
2.3. Получение высокого вакуума.
После загрузки и закрытия вакуумной камеры, откачивается воздух с вакуумной камеры с мишенями. Для этого необходимо запереть 8 клапан и открыть пятый. Получаем давление равное 1 Па.
2.4. Подача рабочего газа.
В камере устанавливается давление 1 Па, которое мы задаем на панели управления. После этого подаем газ Аргон 50% и Кислород 50%. Включение вакуумной установки, прогрев плитки в течении 45 минут и откачка воздуха из паромасляного насоса. Для этого на клапан должен быть открыт, включён форвакуумный насос 6 и включён паромасляный насос 1. Этот процесс нужен для того, чтобы из камеры паромасляного насоса выкачать воздух, так как если его не выкачать, масло начнёт пригорать в реакции с воздухом. На панели управления блока питания напряжение магнетрона задаем 350 В. Время подложек выбираем 10 минут, 15 минут, 20 минут, так как в качестве измерения я выбрал исследование пленок в зависимости от времени.
2.5. Выгрузка подложек.
После того, как все подложки остынут, что занимает минут 10-15, производится напуск воздуха в вакуумную камеру и выгрузка подложек. [3]
3. Контроль измеряемых параметров.
После вышеперечисленных действий, проводятся исследования на толщину пленки с помощью лабораторного микроскопа Ntegra Prina, а также на процент пропускания света в спектрофотометре СФ-2000.
На спектрах пропускания тонких пленок видны периодические пики и впадины, которые обусловлены интерференционными явлениями, что свидетельствует о высоком структурном совершенстве тонких пленок.
Оптические свойства тонких пленок (показатель преломления n(λ), коэффициент поглощения α(λ), коэффициент экстинкции k(λ)) и толщина d могут быть определены из спектра пропускания с интерференционными эффектами, используя конвертный метод [4–7]. Данный метод можно использовать при условии слабого поглощения тонкой пленкой и полностью прозрачной подложки, толщина которой намного больше толщины пленки. Такие условия соблюдаются в настоящей работе.
В табл. 1 указаны характеристики, при которых напыляли пленки ZnO/Si(B)/Si(P)
Таблица 1.
Характеристики, при которых напыляли пленки ZnO/Si(B)/Si(P)
|
Наименование параметров |
Zn 80(нм) |
Zn 100(нм) |
Zn 150(нм) |
Zn 300(нм) |
Si(P)(нм) |
Si(B)(нм) |
|
Температура подложки, °С |
100 |
100 |
100 |
100 |
100 |
100 |
|
Давление в камере, Па |
1 |
1 |
1 |
1 |
1 |
1 |
|
Соотношение газов кислород/аргон, % |
50/50 |
50/50 |
50/50 |
50/50 |
50/50 |
50/50 |
|
Время напыления, (сек) |
50 |
60 |
90 |
180 |
|
|
|
Ток магнетрона, А |
1 |
1 |
1 |
1 |
1 |
1 |
|
Напряжение магнетрона, В |
400 |
400 |
400 |
400 |
400 |
400 |
На Рис 1. приведен спектр пропускания пленок ZnO/Si(B)/Si(P) c cоотношением газов (O2 −50%; Ar-50%)

Рисунок 1. Спектр пропускания пленок ZnO/Si(B)/Si(P)
На Рис. 2 приведен спектр пропускания пленки ZnO/Si(B)/Si(P) второго образца эксперимента №1 (Zn0 80 мм) с конвертными кривыми для проведения расчетов
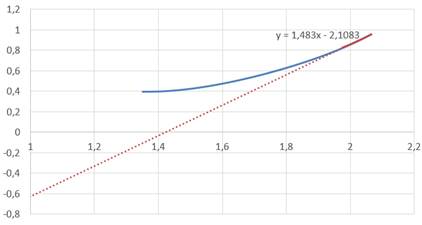
Рисунок 2. График зависимости (αhν) 1/2 = f (hν) для тонких пленок ZnO/Si(B)/Si(P) с толщиной пленки ZnO 80 н.
На Рис. 3 приведен спектр пропускания пленки ZnO/Si(B)/Si(P) для образца эксперимента №2 (Zn0 100 мм) с конвертными кривыми для проведения расчетов.
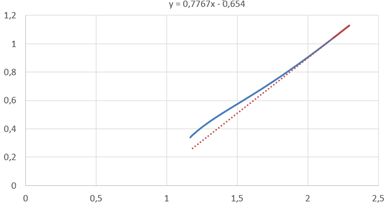
Рисунок 3. График зависимости (αhν) 1/2 = f (hν) для тонких пленок ZnO/Si(B)/Si(P) с толщиной пленки ZnO 100 нм.
На Рис. 4 приведен спектр пропускания пленки ZnO/Si(B)/Si(P) для образца эксперимента №1 (Zn0 150 мм) с конвертными кривыми для проведения расчетов.

Рисунок 4. График зависимости (αhν) 1/2 = f (hν) для тонких пленок ZnO/Si(B)/Si(P) с толщиной пленки ZnO 150 нм.
На Рис. 5 приведен спектр пропускания пленки ZnO/Si(B)/Si(P) для образца эксперимента №1 (Zn0 300 мм) с конвертными кривыми для проведения расчетов.

Рисунок 5. График зависимости (αhν) 1/2 = f (hν) для тонких пленок ZnO/Si(B)/Si(P) с толщиной пленки ZnO 300 нм.
Заключение:
Получены тонкие пленки ZnO/Si(B)/Si(P) с разными толщинами ZnO (80, 100, 150, 300 нм.) методом реактивного магнетронного распыления. Так как полученные значения совпадают с другими исследованиями [8], выявлено, что можно изготавливать тонкие пленки по кодированию структуры для оптического кватерионного процессора.





