Разработка технологического маршрута изготовления емкостного МЭМС акселерометра гребенчатого типа на основе поверхностной микрообработки
Секция: Технические науки
лауреатов
участников
лауреатов


участников



XXXVIII Студенческая международная заочная научно-практическая конференция «Молодежный научный форум: технические и математические науки»
Разработка технологического маршрута изготовления емкостного МЭМС акселерометра гребенчатого типа на основе поверхностной микрообработки
Поверхностная микрообработка основана на осаждении тонких слоев на поверхности кремниевой подложки и травлении одного или нескольких слоев. Преимущества поверхностной микрообработки заключаются в точном контроле размеров в вертикальном направлении, использование односторонней обработки полупроводниковых пластин, простыми способами. Что позволяет получать более высокую плотность интеграции, и обеспечения массовость производства [4], возможность совместимости с ИС, малый размер, а также более низкая стоимость по сравнению с объемной микрообработкой [7]. Обозначения слоев при изготовлении МЭМС акселерометра, а также толщина материалов применяемых в изготовлении данного акселерометра представлены в таблице 1 и 2 соответственно.
Таблица 1.
Обозначения слоев в технологическом маршруте при изготовлении МЭМС акселерометра на основе поверхностной микрообработки

1. Очиcтка подложки кремния осуществляется штатным методом RCA для удаления различных загрязнений перед осаждением слоев рисунок 1(а ) [5].
2. Нанесения слоя изоляции Si3N4. Слой изоляции создаем что при травлении жертвенных слоев не травилась подложка, а также от диффузии примесей в подложку. Данный слой наносим с помощью метода PECVD [6]. Осаждение может происходить при температурах и ниже 400°C рисунок 1(б).

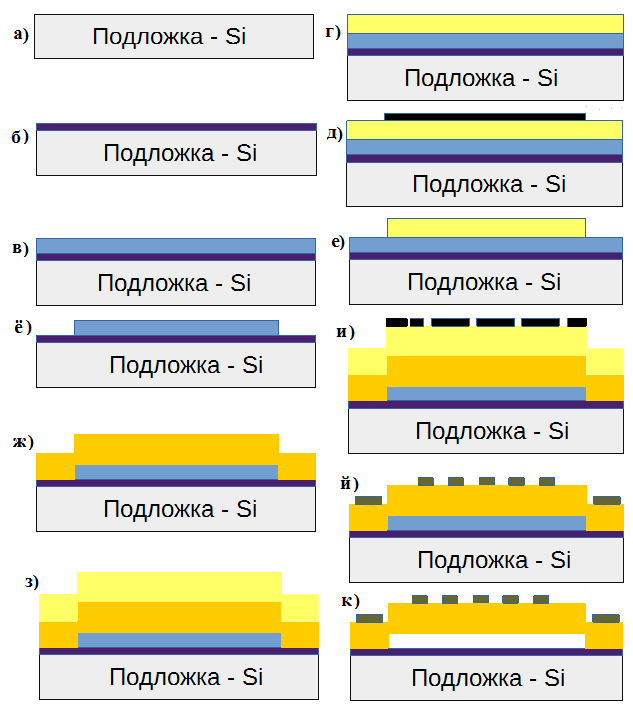
Ричунок 1. Технологический маршрут изготовления гребенчатого емкостного МЭМС акселерометра на основе поверхностной микрообработки гребенчатого емкостного МЭМС акселерометра на основе поверхностной микрообработке
3. В качестве жертвенного слоя было выбрано BSG т.к. оно обладает высокой скоростью травления, а также низким коэффициентом термического расширения, что делает его устойчивыми к термоудару рисунок 1(в) [2].
В данном технологическом маршруте мы наносим боросиликатное стекло (B2O3 – SiO2) методом PECVD с использованием таких реактивных газов как диборан B2H6, моносилан SiH4, закись азота N2O и аргон.
4. Нанесения позитивного фоторезиста методом центрифугирования и фотошаблона рисунок 1(г).
5. Нанесения фотошаблона рисунок 1(д).
6. Фотолитография, вскрытие якорных областей рисунок 1 (е).
7. Удаления ненужного БСС используя реактивное ионное травления рисунок 1(ё). Газы, используемые для травления, как правило, представляют собой комбинацию гексафторида серы SF6 и другого газа, облегчающего процесс травления. Пример комбинацию SF6 и Ar для травления боросиликатного стекла [3].
8. Осаждения поликремния методом PECVD рисунок 1(ж). Поликремний является основным конструктивным материалом акселерометра.
9-10.Нанесения фоторезиста и фотошаблона на фоторезист рисунок 1 (з,и).
11. Фотолитография, вскрытие областей под реактивное ионное травления поликремния.
12. Травления поликремния. формирование элементов конструкции.
В качестве рабочего вещества при ПХТ кремния и его соединений обычно используется тетрафторметан CF4. Основой процесса травления является реакция между фтором и кремнием с образованием четырехфтористого кремния SiF4 – соединения, летучего при температуре выше 359К. В общем виде эту реакции можно записать как:

13. Удаления фоторезиста (различными способами).
14-15.Нанесения фоторезиста и фотошаблона, вскрытие областей под металл.
16.Нанесения металла с помощью магнетронного распыления на постоянном токе.
17. Взрывная фотолитография удаления фоторезиста с фотошаблоном и ненужным металлом рисунок 1(й).
18. Очистка контактов.
19. Отжиг контактов.
20. Удаления боросиликатного стекла с помощью 49% плавиковой кислоте (при комнатной температуре) в течение 1.5–2 минут. За тем несколько минут в деионизированной воде, и в спирте, затем поместить в сушильный шкаф на 10 минут при температуре 110°С [1].
21.Реализация конструкции рисунок 1(к).
22. Скрабирование, ломка на чипы.
23. Установка в корпус.
24. Разварка выводов. Металлы активные к окислению хуже поддаются разварки, примером такого металла может служить алюминий.
25. Герметизация контроль герметичности.
26. Испытания устройства.
27. Маркировка.
28. Сдача на склад.
Таблица 2.
Толщина конструктивных материалов используемых при изготовлении акселерометра
|
Слой материала |
Толщина, мкм |
|
Si3N4 |
0.6 |
|
БСС |
2.0 |
|
Поликремний |
4 |
|
NiV |
0.5 |
В результате выполнения последовательных операций мы изготовили конструкцию емкостного микроакселерометра на основе поверхностной микрообработке. Данная конструкция емкостного гребенчатого акселерометра с одной осью чувствительность может быть реализована в автомобильных подушках безопасности.
Список литературы:
1. Cowen Allen, Hardy Busbee, Mahadevan Ramaswamy, [et al.]. a MUMPs® process PolyMUMPs Design Handbook. – [Electronic source] http://inst.cs.berkeley.edu/~ee245/fa08/handouts/PolyMUMPs.DR.v11.pdf (date of the application 30.05.2016).
2. Filmetrics. Refractive Index of BSG, Borosilicate Glass, Microscope Slide – [Electronic source]http://www.filmetrics.com/refractive-index-database /BSG/Borosilicate-Glass-Microscope-Slide(date of the application 30.05.2016).
3. Huang Ann Christine. Process characterization of the reactive-ion etching of borosilicate glass for microfluidic channels. M.Sc., A Thesis presented to the Faculty of California Polytechnic State University, San Luis Obispo. August 2010. P.60.
4. MEMS Nanotechnology Exchange. Fabricating MEMS and nanotechnology. – [Electronic source] – https://www.memsexchange.org/MEMS/fabrication.html (date of the application 30.05.2016).
5. RCA clean. – [Electronic source] – http://inside.mines.edu/~ sagarwal/phgn435/Clean.htm (date of the application 29.05.2016).
6. Silicium nitride, LPCVD and PECVD deposition. Stress control. Deposition of silicon nitride layers. Si3N4. – [Electronic source]https://www.crystec.com/kllnitre.htm (date of the application 30.05.2016).
7. Yazıcıoglu Refet Fırat. Surface micromachined capacitive accelerometers using mems technology. M.Sc., Department of Electrical and Electronics Engineering Supervisor: Assoc. Prof. Dr. Tayfun Akın. August 2003, P. 232.

